Equipment solutions enabling AI
Engineering
the Intelligent
Future
Corporate
Facts, numbers, and footprint
Global talent
300 employees worldwide, our staff is comprised of 220+ engineers who can deliver high-quality semiconductor products for our customers' needs.
Robust IP
With more than 100 patents, pending patents, and trade secrets, we operate on the cutting edge of technology, delivering advanced technology with our products.
Proven products
We have delivered 1,000+ tools to over 100 fabs across the world, confirming our position as an established semiconductor equipment provider.
Global Footprint

Global Headquarters,
R&D and NPI
3178 Laurelview Ct. Fremont, CA 94538
+1 (510) 954-6889
Advanced Technology Center and Wet Processing Group
3200 W. Germann Rd. Chandler, AZ 85286
+1 (602) 740-7179
Manufacturing
SF No. 253, No. 96/3, Vadakku Sambala Thottam Kannampalayam, Sulur Taluk, Tamil Nadu 641402, India
+1 (888) 937-3637
Engineering and R&D
Export Promotion Industrial Park 8 Crystal Kalyani Platina, EPIP Zone, Brookefield, Bengaluru, Karnataka 560037, India
+1 (888) 937-3637B-6, 1st Floor, Elysium Central, Puliakulam Rd
+1 (888) 937-3637
Ramaliga Chettiyar Layout, Coimbatore, Tamil Nadu
641045, India
Sales & Service
7F.-2, No. 6, Taiyuan 1st St., Zhubei City, Hsinchu County 302082, Taiwan
+1 (888) 937-3637a1508, 27 Dongtancheomdansaneop 1-ro, Hwaseong-si,
+1 (888) 937-3637
Gyeonggi-do, 18469 South Korea3-28-12 Meieki, Nakamura Ward, Nagoya, Aichi 450-0002,
+1 (888) 937-3637
JapanWestendstraße 28, 60325 Frankfurt am Main Germany
+1 (888) 937-3637



-min.avif)







-min.avif)


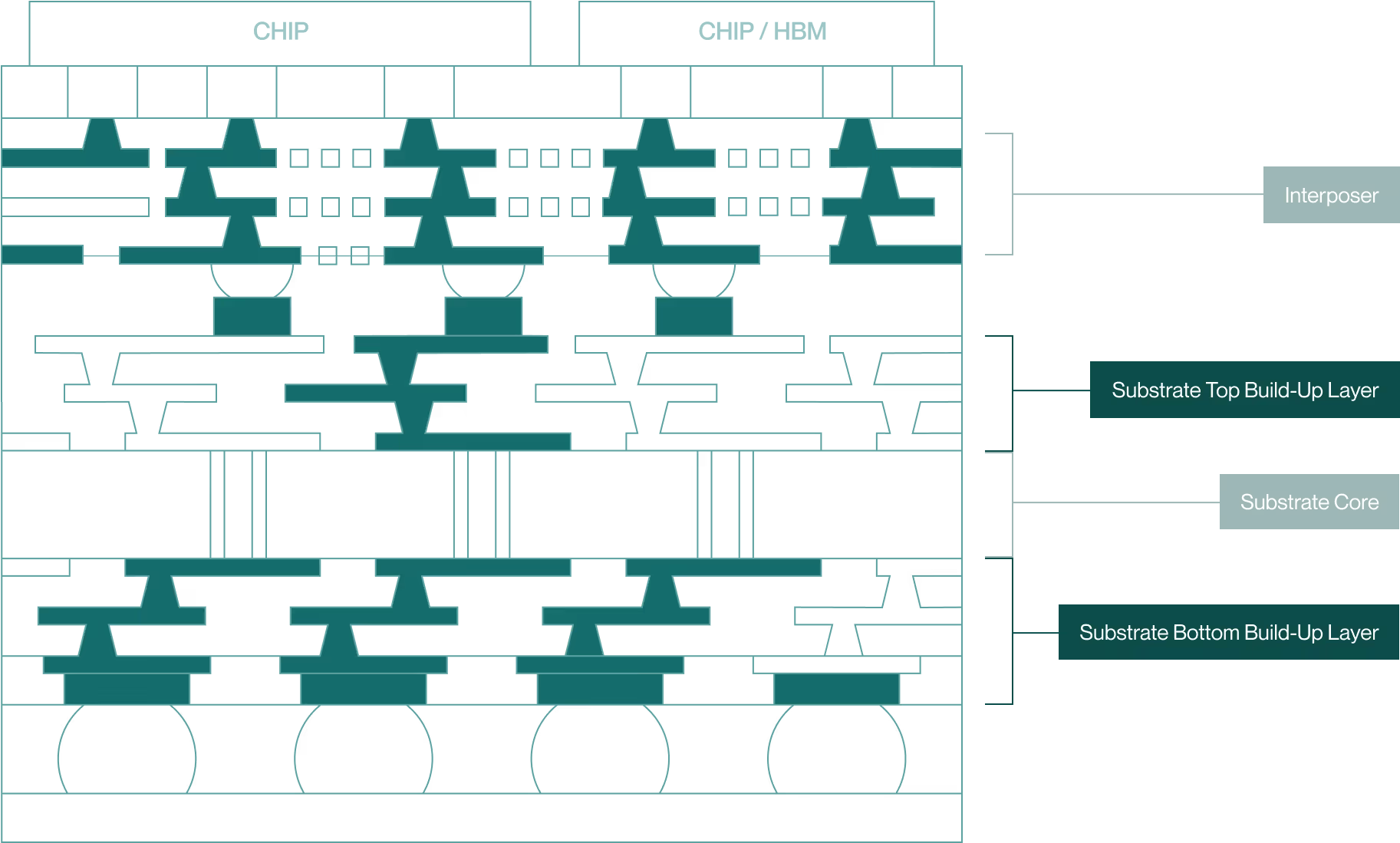
-min.avif)

.png)

.png)
.avif)

.avif)
.avif)
.avif)

.avif)

%20copy.avif)



-min.avif)














